Maîtriser l'art de souder des tableaux de grille à billes
La position d'un emballage semi-conducteur efficace et fiable ne peut pas être surestimée dans le monde en évolution rapide de la fabrication électronique des appareils.La technologie Ball Grid Array (BGA) apparaît comme une solution idéale pour répondre aux exigences croissantes de l'électronique moderne pour des performances plus élevées et une miniaturisation.Cet article creuse dans les détails complexes de la technologie BGA, explorant ses composants ultimes, ses processus et les défis techniques qu'il aborde dans l'emballage de semi-conducteurs.De la structure de base et des avantages du BGA par rapport aux systèmes traditionnels à base de broches comme le quad plat aux processus sophistiqués de soudure, d'inspection et de reprise, le discours offre une analyse complète.Catalogue

Figure 1: tableau de la grille à billes
Bases des réseaux de grille à billes
Un réseau de grille à billes (BGA) est une solution moderne dans l'emballage semi-conducteur, conçu pour surmonter les défis des méthodes plus anciennes basées sur des broches comme le quad plate.Au lieu d'utiliser des épingles fragiles, le BGA s'appuie sur une gamme de petites boules de soudure.Ces balles sont positionnées avec précision sur le dessous de l'emballage et sont censées se connecter avec des tampons en cuivre assortis sur une carte de circuit imprimé (PCB).Lorsqu'ils sont chauffés, les boules de soudure fondent et fixent le BGA à la planche, créant une connexion forte et fiable.
Le format BGA offre plusieurs avantages pratiques.Tout d'abord, il simplifie la disposition des PCB en réduisant le besoin d'interconnexions densément emballées selon lesquelles les systèmes d'emballage antérieurs requis.Cette disposition plus efficace rend le BGA plus durable et réduit le risque de dommages pendant la manipulation, contrairement aux épingles délicates trouvées dans les paquets plus anciens qui peuvent se plier ou se casser facilement.
De plus, le BGA offre une gestion de chaleur et des performances d'efficacité électrique supérieures.La connexion courte et directe entre le BGA et le PCB aide à dissiper plus efficacement la chaleur, ce qui aide à maintenir la stabilité des circuits sous contrainte thermique.De plus, les trajets électriques plus courts au sein du BGA réduisent la perte de signal, ce qui est particulièrement substantiel pour les dispositifs fonctionnant à des fréquences élevées.Cette combinaison de durabilité, de dissipation de chaleur et d'efficacité électrique fait de l'emballage BGA un choix de plus en plus populaire pour les appareils électroniques modernes à mesure que leur complexité et leurs demandes de performance augmentent.
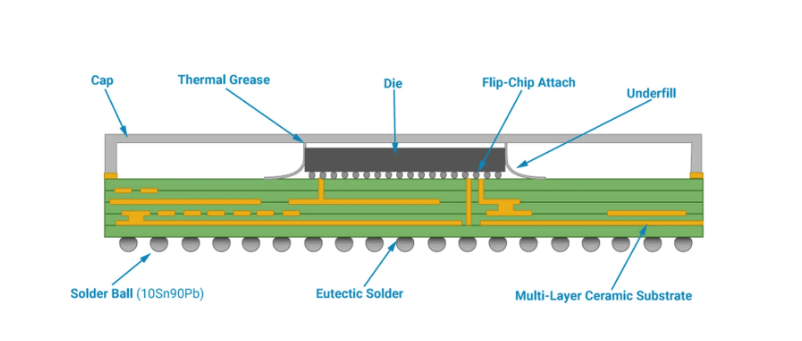
Figure 2: processus de soudage BGA
Naviguer dans le processus de soudure BGA
Le processus de soudage d'un tableau de grille à billes (BGA) a été initialement remis en question en raison de préoccupations concernant sa fiabilité et la difficulté d'inspecter les connexions cachées sous le composant.Néanmoins, au fil du temps, le soudage BGA s'est avéré plus fiable que les systèmes plus anciens, comme les packs quadrums, grâce à un contrôle précis pendant le processus de soudage.Cette fiabilité améliorée a conduit à son utilisation généralisée dans les ensembles de PCB de fabrication à grande échelle et de PCB plus petits.
La méthode de soudage de reflux est dominante pour attacher un BGA à une carte de circuit imprimé (PCB).Dans ce processus, l'ensemble entier est chauffé à une température spécifique où la soudure sous le BGA fond en un état semi-liquide.Cette étape est soigneusement contrôlée pour s'assurer que la soudure maintient sa structure et ne fait pas s'effondrer ou fusionner les boules de soudure.La régulation précise de la température est grave car toutes les fluctuations peuvent affecter la qualité des connexions.
Une caractéristique étendue du processus de reflux est la façon dont la soudure en fusion se comporte.Sa tension en surface naturelle aide à tirer le BGA en alignement parfait avec les coussinets PCB, même si le composant était légèrement décentré lorsqu'il était placé.Cette capacité d'auto-correction garantit que chaque connexion est correctement établie sans ajustements manuels.Ces techniques avancées rendent non seulement le soudage BGA très fiable mais aussi plus efficace, contribuant à faire de la BGA une option préférée dans la production de bandes de circuits imprimées.
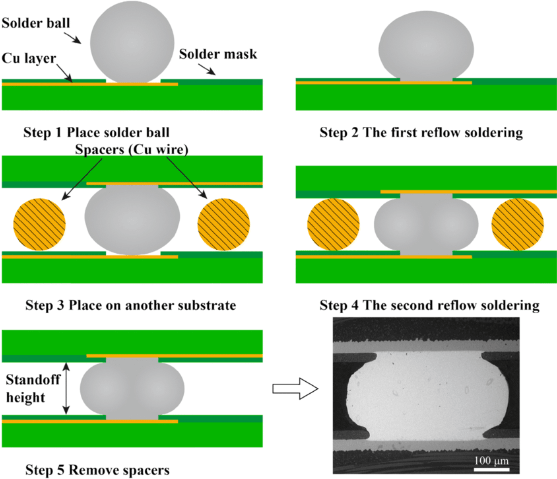
Figure 3: Inspection des joints de soudure BGA
Comment inspecter efficacement les joints de soudure BGA?
L'inspection des joints de soudure BGA est une partie insistante du processus d'assemblage, compliqué par le fait que les joints sont cachés sous la composante BGA.Étant donné que l'inspection visuelle traditionnelle ne peut pas accéder à ces connexions dissimulées, les techniques de radiographie et d'inspection des rayons X automatisées (AXI) sont utilisées pour obtenir une vue claire et non invasive des joints de soudure.
L'inspection des rayons X est utile pour vérifier approfondie chaque joint de soudure.L'imagerie permet aux techniciens de s'assurer que toutes les boules de soudure ont fait fondre correctement et ont formé de fortes liaisons avec le PCB.Cette étape est utilisée pour identifier des problèmes comme les articulations froides, où la soudure n'a pas complètement fondu, ou vides, qui sont des poches d'air qui peuvent affaiblir l'articulation au fil du temps.
Grâce à la technologie des rayons X, les inspecteurs peuvent confirmer que la quantité appropriée de chaleur a été appliquée pendant le processus de reflux et que les joints de soudure répondent aux normes précises.Ce niveau de contrôle garantit que le produit final est fiable et capable de résister aux contraintes opérationnelles auxquelles elle peut être confrontée, aidant à maintenir une qualité de fabrication élevée.
Stratégies efficaces pour les retouches de BGA en électronique
Le retravailleur d'un composant BGA est une tâche très précise qui nécessite un contrôle minutieux du processus de chauffage.Ce travail se fait généralement dans une station de repensage spécialisée équipée d'outils conçus spécifiquement pour le travail.Le chauffage infrarouge localisé est utilisé pour cibler le BGA sans surchauffer les pièces à proximité.Une fois que la soudure sous le composant fond, un outil à vide soulève soigneusement le BGA de la planche.Tout au long de ce processus, la chaleur doit être contrôlée précisément pour éviter d'endommager les composants adjacents, soulignant la nécessité d'un équipement de reprise avancé.
Une reprise réussie de BGA dépend du maintien de paramètres de température précis et du contrôle de l'environnement autour du composant.Cela empêche les circuits environnants d'être affectés lors de l'élimination et du remplacement d'un BGA défectueux.La tâche exige une compréhension approfondie du fonctionnement des BGAS et de la manipulation qualifiée pour s'assurer que le processus est effectué correctement.En raison de ces complexités, BGA Rework est une opération délicate qui nécessite à la fois le bon équipement et les techniciens expérimentés pour maintenir l'intégrité de l'ensemble de l'assemblage.

Figure 4: Modèles de terrain BGA PCB
Stratégies de conception pour les modèles de terrain BGA PCB
La conception de modèles de terrain PCB pour les BGAS nécessite une attention précise aux détails pour assurer une connexion fluide et sécurisée pendant l'assemblage.Les motifs terrestres doivent être parfaitement alignés avec la grille du BGA, garantissant que chaque balle de soudure s'aligne avec précision avec le coussin correspondant.Des fonctionnalités de conception clés comme le soulagement du masque de soudure, et dans certains cas, laissant les coussinets découverts par le masque, sont utilisés pour permettre à plus de soudure de s'écouler et de créer une liaison plus forte.L'adhésion stricte aux normes IPC est utile pour atteindre le niveau de précision recherché pour une soudure BGA réussie.
Chaque aspect du modèle terrestre doit être soigneusement planifié pour répondre aux exigences spécifiques de la composante BGA.Cela comprend l'ajustement de la taille des coussinets et la gestion soigneusement des tolérances de position pour s'assurer que chaque connexion est parfaite.La planification réfléchie au stade de la conception garantit que le processus de soudage est à la fois efficace et fiable, aidant le BGA à attacher en toute sécurité et fonctionne correctement dans l'assemblage de PCB.
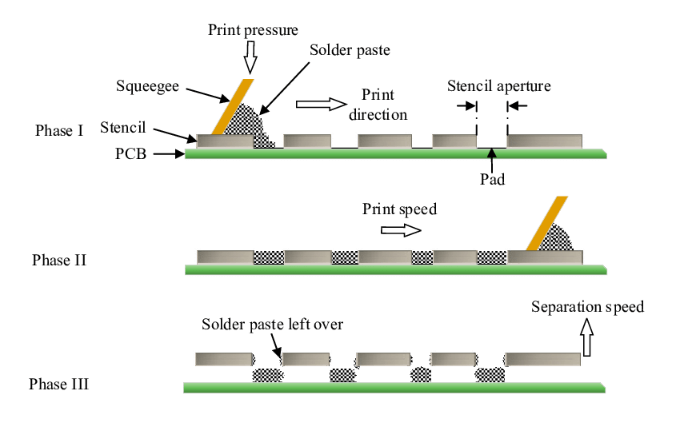
Figure 5: impression de pâte de soudure BGA
Atteindre une précision dans l'impression de pâte de soudure BGA
L'application de la pâte de soudure pour l'assemblage BGA nécessite des techniques de pochage précises pour garantir que de petites quantités exactes de pâte sont déposées sous chaque boule BGA.Ce processus utilise des pochoirs de coupe laser qui sont parfaitement alignés avec les motifs de terre PCB.Pour améliorer davantage la précision et minimiser les défauts comme les balles de soudure, ces pochoirs sont souvent traités avec des nanocoats.Les têtes d'impression miniature contrôlent ensuite soigneusement la quantité de pâte appliquée à chaque pavé, tandis que les systèmes de vérification optique vérifient que la pâte est placée avec une haute précision.
Le type de pâte de soudure utilisée - typiquement type 3 ou type 4 - dépend de la viscosité recherchée pour l'assemblage spécifique.Le choix de la pâte a un impact direct sur la façon dont les joints de soudure se forment pendant le processus de reflux.Étant donné que cette étape jette les bases de la force et de la fiabilité des connexions finales, le processus d'impression de la pâte de soudure est une partie dangereuse de l'assemblage BGA, nécessitant une attention particulière aux détails pour garantir des résultats de haute qualité.
Complexités de la soudure BGA
Le soudure BGAS présente des difficultés uniques car les joints de soudure sont cachés sous le composant, ce qui rend l'inspection visuelle directe impossible.Pour y remédier, des outils spécialisés comme les machines à rayons X sont utilisés pour inspecter les connexions, tandis que les stations de repensage infrarouge permettent un réalignement précis du composant en cas de besoin.La gestion du processus de soudage nécessite également un contrôle minutieux de la chaleur pour éviter de souligner les joints de soudure, ce qui peut entraîner des fissures.De même, toutes les boules de soudure doivent maintenir la même hauteur (coplanarité) pour garantir des performances cohérentes et une fiabilité à long terme.
Les facteurs environnementaux tels que le vieillissement et la sensibilité à l'humidité compliquent encore le processus.Ces problèmes doivent être étroitement contrôlés pour éviter la détérioration des joints de soudure au fil du temps.La navigation avec succès de ces défis exige une compréhension approfondie des techniques de soudage BGA et de l'utilisation d'équipements avancés.
Différents types de réseaux de grille à billes
La technologie BALL Grid Array (BGA) est une méthode de montage des circuits intégrés (ICS) sur les cartes de circuits imprimés (PCB) qui améliorent la connectivité électrique et la dissipation de chaleur.Il utilise un tableau de boules de soudure sous le composant pour créer des connexions sécurisées.

Figure 6: tableaux de grille à billes en plastique (PBGA)
Les BGAS en plastique sont largement utilisés car ils sont abordables et offrent des performances fiables pour la plupart des applications standard.Ils se composent d'un substrat en plastique avec des boules de soudure attachées en dessous.Ceux-ci se trouvent souvent dans l'électronique grand public, les systèmes automobiles et d'autres appareils qui ne fonctionnent pas dans des conditions extrêmes.Leur conception simple offre une bonne connectivité électrique et une gestion modérée de la chaleur, ce qui est suffisant pour un usage quotidien.
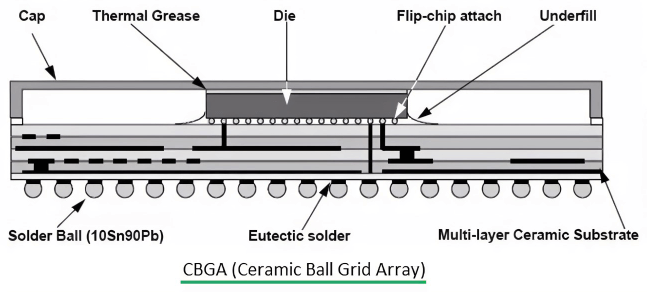
Figure 7: Tableaux de grille à billes en céramique (CBGA)
Les BGA en céramique utilisent un substrat en céramique, les rendant plus résistants à la chaleur et aux interférences électriques que les BGAS en plastique.Cette durabilité les rend idéaux pour des environnements exigeants comme les télécommunications, l'aérospatiale et les serveurs haut de gamme.La céramique offre une excellente isolation et peut gérer à la fois des températures élevées et une contrainte mécanique, garantissant la fiabilité à long terme de l'appareil.
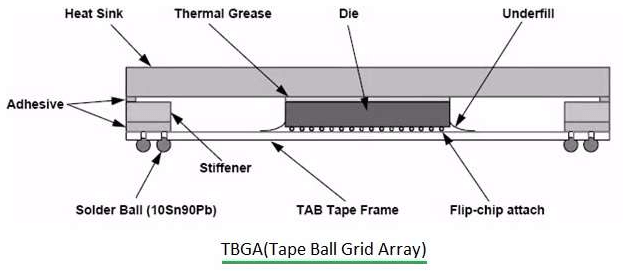
Figure 8: Tape Bgas (TBGA)
Les BGAS de bande sont conçus avec un substrat flexible qui peut être conforme à la surface du PCB, améliorant à la fois la connexion mécanique et la dissipation de chaleur.Ces BGAS sont idéaux pour l'électronique portable et les dispositifs à haute densité où l'espace est limité.La nature flexible du substrat permet une meilleure gestion thermique dans les espaces compacts, ce qui en fait un choix préféré pour les smartphones et autres appareils portables.
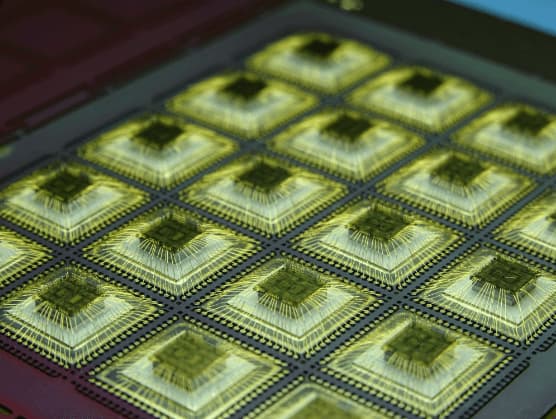
Figure 9: Die BGAS empilée
Les BGAS de matrice empilés sont utilisés dans les appareils qui doivent emballer beaucoup de puissance de traitement dans un petit espace.Ce type empile plusieurs circuits intégrés verticalement dans un seul package, permettant plus de fonctionnalités sans augmenter la taille de l'appareil.Les BGAS empilés se trouvent couramment dans les smartphones, les tablettes et autres électroniques compacts qui nécessitent des performances élevées dans un petit facteur de forme.
Conclusion
L'exploration de la technologie Ball Grid Array (BGA) souligne son rôle clé dans le paysage de fabrication de l'électronique moderne.Comme détaillé dans cet article, l'emballage BGA aborde non seulement les limites physiques des méthodes d'emballage plus anciennes, mais améliore également considérablement les performances grâce à une meilleure gestion de la chaleur et à l'efficacité électrique.Les processus techniques impliqués dans le soudage, l'inspection et les retouches de BGA reflètent un engagement envers la précision et la fiabilité, garantissant que les appareils électroniques répondent aux exigences strictes des normes technologiques d'aujourd'hui.
De plus, les différents types de BGAS, des BGAS plastiques à la haute conductivité thermique, les BGAS supérieurs en métal s'adaptent à un large éventail d'applications, prouvant la polyvalence et l'adaptabilité de la technologie BGA.En fin de compte, alors que les appareils électroniques continuent d'évoluer en complexité et en fonctionnalité, la technologie BGA restera requise, continuant à générer des innovations et à maintenir des normes élevées de qualité dans l'emballage de semi-conducteurs.
Questions fréquemment posées [FAQ]
1. Comment souder un package BGA?
Préparation: Commencez par nettoyer l'emballage BGA et le PCB (Circuit Circuit Circuit) pour supprimer tous les contaminants ou résidus.
Alignement: Alignez soigneusement le package BGA sur le PCB, en vous assurant que tous les coussinets sur la puce s'alignent avec les coussinets correspondants sur la carte.
Soudure: Utilisez un processus de soudage de reflux.Placez le PCB avec le BGA dans un four de reflux.La soudure déjà appliquée aux coussinets fondera et formera des connexions pendant le cycle de chauffage.
Refroidissement: Laissez le PCB refroidir lentement après le processus de reflux pour éviter toute contrainte thermique.
2. Qu'est-ce que BGA en soudage?
BGA représente le tableau de la grille à billes.Il s'agit d'un type d'emballage de montage en surface utilisé pour les circuits intégrés.Les forfaits BGA utilisent de minuscules boules de soudure fixées au dessous du package pour établir des connexions électriques avec le PCB au lieu des fils traditionnels.
3. Comment faire du soudage à balle?
Placement de balle: Appliquer la pâte de soudure sur les coussinets PCB où le BGA sera placé.Positionnez le BGA afin que chaque balle de soudure s'aligne avec le coussin correspondant sur le PCB.
Soudeur de reflux: Chauffer l'assemblage dans un four de reflux.La pâte de soudure fondera, liant les boules de soudure aux coussinets et créant une connexion électrique et mécanique solide.
Inspection: Après la soudure, inspectez les connexions pour tout ponts ou articulations pauvres, en utilisant généralement l'inspection des rayons X pour voir sous le BGA.
4. Comment vérifier le soudage BGA?
Inspection visuelle: Initialement, vérifiez tout désalignement ou défaut visible autour du package BGA.
Inspection des rayons X: Étant donné que le soudage BGA ne peut pas être entièrement vérifié visuellement en raison de la nature cachée des connexions, utilisez l'inspection des rayons X pour examiner les joints de soudure sous le BGA.
Test fonctionnel: Enfin, effectuez des tests électriques pour garantir que toutes les connexions fonctionnent correctement.
5. Quelle température devrait être la soudure BGA?
Températures typiques: La température précise de la soudure BGA dépend de la pâte de soudure utilisée.En règle générale, la pâte de soudure sans plomb nécessite des températures autour de 217 ° C à 245 ° C.Vérifiez les spécifications du fabricant de pâte de soudure pour les températures exactes.
Profil de reflux: Suivez un profil thermique spécifique qui chauffe progressivement l'assemblage à la température de reflux requis, le maintient là-bas suffisamment longtemps pour assurer la fusion appropriée de la soudure, puis la refroidit progressivement pour éviter la contrainte thermique.